銅箔基板檢測
銅箔基板(Copper Clad Laminate,CCL)是 PCB 的上游關鍵材料,廣泛用於通訊系統、消費電子、交通與電力系統,或是用於高頻高速網路設備的持續升級等。目前銅箔基板的全球市場年產值約在 16.4–18.8B(美元)(2023–2025),CAGR 約 5.6–6.1%1。近期市場評估 成長動能會落在5G 基礎建設、AI 伺服器、智慧充放電裝置等等需求。


圖1 銅箔基板市場趨勢與全球市佔比例
銅箔基板的結構是由銅箔(導電層)與介電基材/增強材(玻纖布、不織布、紙基)所組成,並以樹脂(環氧、酚醛、PI、PTFE)含浸層壓;可為單面、雙面或多層。其中銅箔類型可分為電解銅箔(ED,剛性板通用)或是與壓延銅箔(RA,軟板/彎折需求);而介電基材與增強材可分為樹脂FR‑4(通用)、具有高玻璃轉移溫度(Tg)與低介電常數和低損耗因子( Dk/Df)的玻璃纖維(適用高速/高頻應用)、或是PI/陶瓷/PTFE(適用高溫環境或 是RF應用);部分使用金屬核/複合基材來應對高功率與散熱關鍵場景。

圖2 銅箔基板素材示意圖
過往業界透過AOI檢測,主要用來辨識與篩選可見光影像,位於表面的缺銅、刮傷、汙染等;然而在基板本身因材料或是製程產生的空洞、裂縫、結構撓曲、層壓分層與厚度/密度不均等瑕疵,必須透過X光影像才能檢出。本次檢測樣本即為雙面銅箔覆合於不織布基材之板件,透過X光影像來辨識被遮蔽之刮痕,以及分層、密度不均與厚度變化等內部缺陷。
我們採用高解析度 X 光源,調整放大倍率與擷取參數,並搭配影像處理強化銅箔/不織布對比。透過刀具對不織布介材製作刮痕(寬≈0.5 mm、長≈15 mm、深≈0.1 mm),再比較以銅箔覆蓋/未覆蓋的影像差異。除進行影像辨識外,也沿指定路徑擷取像素吸收值,繪製像素值分布曲線,來評估厚度/密度變化。



圖3 銅箔基板原始測試樣件、測試刮痕位置與銅箔覆蓋的可見光比對圖


圖4 銅箔基板測試刮痕位置與銅箔覆蓋後的可見光比對放大圖


圖5 銅箔基板測試刮痕位置與正常基板位置X光影像
透過X光影像辨識,可清楚分辨不織布紋路與雙層銅箔結構;同時在模擬單層銅箔、與雙層銅箔的狀況,摺痕、刮痕與不織布介材結構在 X‑ray 影像都清晰可見。底下為刮痕在單層銅箔上層裸露,以及雙層銅箔覆蓋兩種情況下,局部放大影像以及標記刮痕位置。


圖6 銅箔基板測試刮痕於單層銅箔無覆蓋位置與放大後X光影像

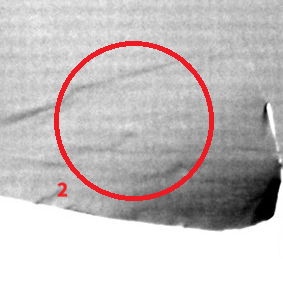
圖7 銅箔基板測試刮痕於雙層銅箔覆蓋位置與放大後X光影像
在影像量測量化方面,以像素吸收值(灰階)沿指定路徑擷取,建立位置‑吸收曲線,並解析斜率與峰谷,以量化厚度/密度趨勢,進一步設定Δ吸收值門檻與變異係數作為製程管制指標。可以明顯看出板材厚度在該方向有明顯變化。


圖8 取樣路徑像素值分析與分佈曲線
未來的產品檢測,尤其是線上(in‑line)即時品管,將透過AOI+AXI 串聯:AOI 進行表面高速篩檢,而AXI則 穿透結構找出瑕疵,聯合判定提升良率。針對大型原材料物件,如500 mm (長) x 500 mm (寬) x 1mm (厚) ,採用高解析度影像、多點位連續拍攝方式,可達成產線全檢之需求。
惠茲科技的PortalX影像平台可提供即時動態影像,滿足客戶線上檢測。我們的模組化與高度客製化設計,不但可以串接客戶自有之自動化設備與產線,還能掛載智慧演算法與統計製程控制(Statistical Process Control, SPC),建立像素值‑物理量對應模型,輸出厚度趨勢、密度不均指標、空洞比例等,也能整合製造執行系統(Manufacturing Execution System, MES),追溯檢測結果與批次、配方、機台、進行影像與分析結果歸檔,對於後續肇因分析(Failure Analysis, FA)可提供完整數據與驗證方式。
1 Copper Clad Laminates Market (2024 - 2030)
https://www.grandviewresearch.com/industry-analysis/copper-clad-laminates-market-report